 English
English
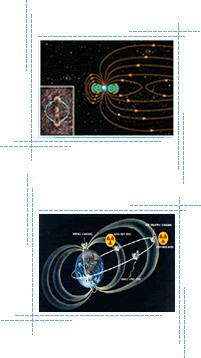
在当前宇航器件和电路抗辐射设计过程中,激光模拟单粒子效应已经是对器件及电路预评估的重要手段,除了成本较低、平台开放、实验自由,并能一定程度等效重离子LET值等优势外,还有一个无可比拟的重要原因就在于能够准确定位器件发生单粒子效应的薄弱区域,从而帮助器件及电路设计者更好的进行有针对性的评估及改进。
传统上,对器件薄弱点的定位虽然可以通过激光扫描实现,但是仍然离不开测试者的实时观察和大量的手动调节操作,测试效率有待提高。空间中心依托中科院重点部署项目,研制了单粒子效应测绘系统(如图1),实现了位置移动、激光注入和器件检测的时空同步,通过集成模块化的单粒子效应检测电路,可以实现对器件SEL、SEU和SET敏感点分布的自动实时的绘图显示。

图1 单粒子效应激光测绘系统
测绘系统的测试间距、测试范围、移动速度、辐照频率均可调节,以满足测试需要及检测的时序要求。以SRAM的SEU测试为例,我们可以以较大间距对器件的较大范围进行激光扫描,如图2所示为以5μm间距扫描器件1000×1000μm范围的翻转测绘图和数据,不同颜色代表着单位及多位翻转,由图可以监视器件的翻转情况,清晰的获得器件存储资源分布。

图2 SRAM SEU激光测绘图及翻转数据,5μm间距
我们也可以以较小间距观察SRAM器件单个存储位或相邻存储位的薄弱点分布情况,如图3所示为以0.1μm间距扫描器件2×2μm范围的翻转测绘图和数据,可以清晰的看到两个相邻存储位的翻转位置分布趋势,其中在两个存储位的交界处可能诱发其同时翻转。

图3 SRAM SEU激光测绘图及翻转数据,0.1μm间距
该测绘系统也不仅仅适用于SRAM,通过一定的数据交互及接口设计,可以满足任何大规模集成电路的测试需要。当然,一次扫描的结果仍然不可避免具有一定随机性和误差,通过多次试验可以更精确的获得器件的薄弱点分布。
最后总结一下测绘系统的特点:
激光注入时间和位置与器件检测同步,保证一个注入点一次激光注入和一次检测
实时显示SEE发生位置
测绘间距和频率可调
任意指定时间和任意指定位置的激光注入
快速测绘器件资源分布
快速薄弱点定位及绘图