 English
English
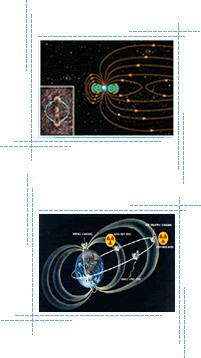
国内外大量的空间飞行实践表明,空间带电粒子诱发的充放电效应(SESD,Spacecraft charging induced Electro-Static Discharge)是空间天气导致航天器故障的主要方式之一,且故障现象主要表现为星用电子器件和电路系统出现数据或逻辑状态跳变、工作模式非受控切换、执行机构操作异常等可恢复性“软错误”。由于SESD故障宏观现象与单粒子效应(SEE,Single Event Effects)故障相似,航天工程应用常常将二者笼统地归为后者进行处置,导致SESD的真正危害长期得不到准确认知和正确应对、一直是威胁航天器在轨安全可靠的重要空间天气问题。
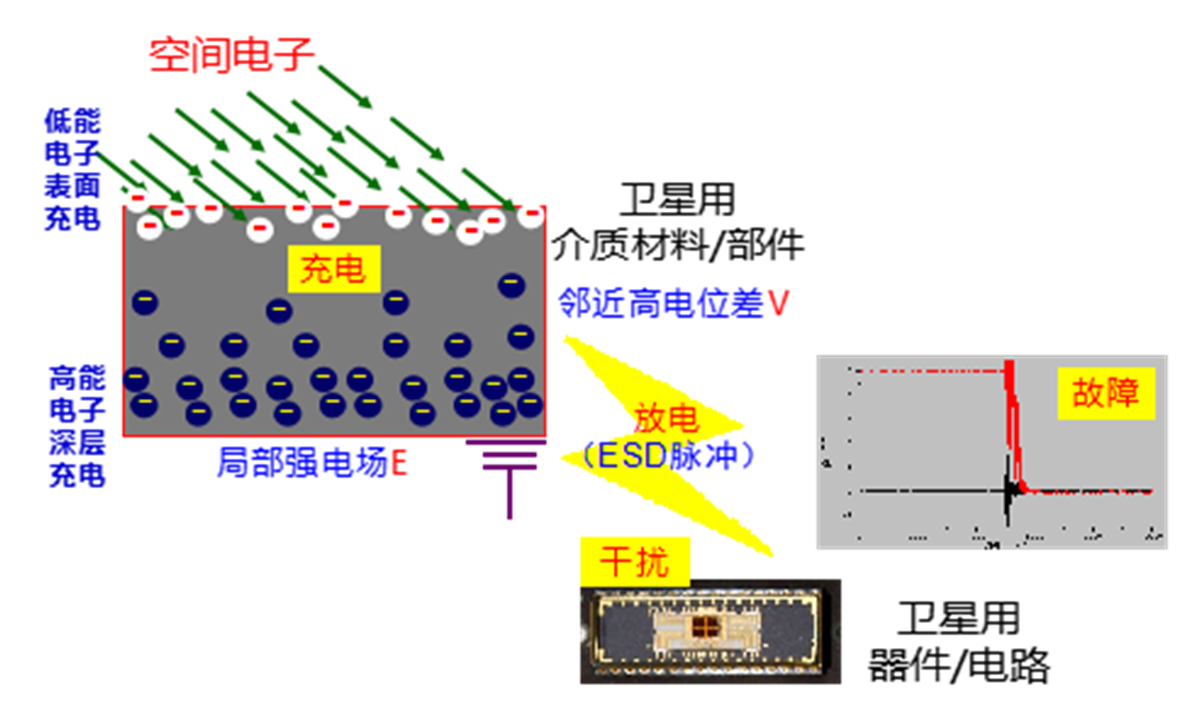
图1. 空间充放电致星用器件电路故障的原理
国家空间科学中心太阳活动与空间天气重点实验室陈睿副研究员、韩建伟研究员团队以130 nm SOI工艺制备的DFF时序逻辑电路为对象,初步研究揭示了SESD导致星用DFF电路故障的特征规律、敏感区域与微观机制,建立了SESD干扰源模型,确立了致电路出错的关键阈值参数,为建立完整的SESD致星用器件电路故障模型奠定了核心基础。
研究表明,时序电路中的复位和电源端口对SESD敏感,且复位信号的误识别和PMOS的可恢复击穿是产生“软错误”的主要机理。提出了阻尼衰减正弦振荡脉冲SESD干扰源模型,具体特征与参数如下公式和图例所示。其中,SESD脉冲主峰的幅值(A)与脉宽(τ)是诱发DFF产生软错误的主要特征参数,导致该DFF存储数据出错的正/负向SESD脉冲幅度与脉宽阈值分别约为1.2 V、0.6 ns 和 -0.64 V、20 ps。

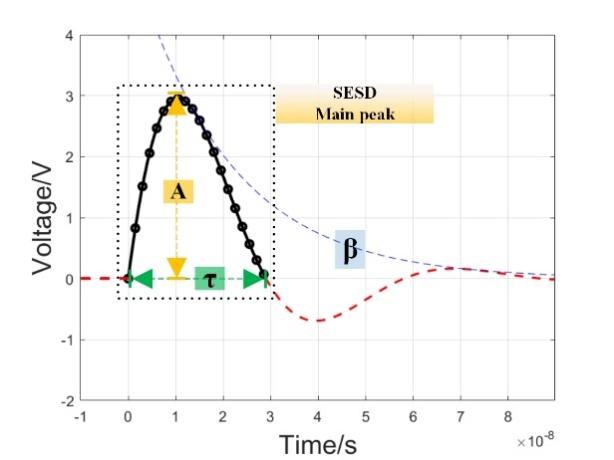
图2. SESD干扰源模型
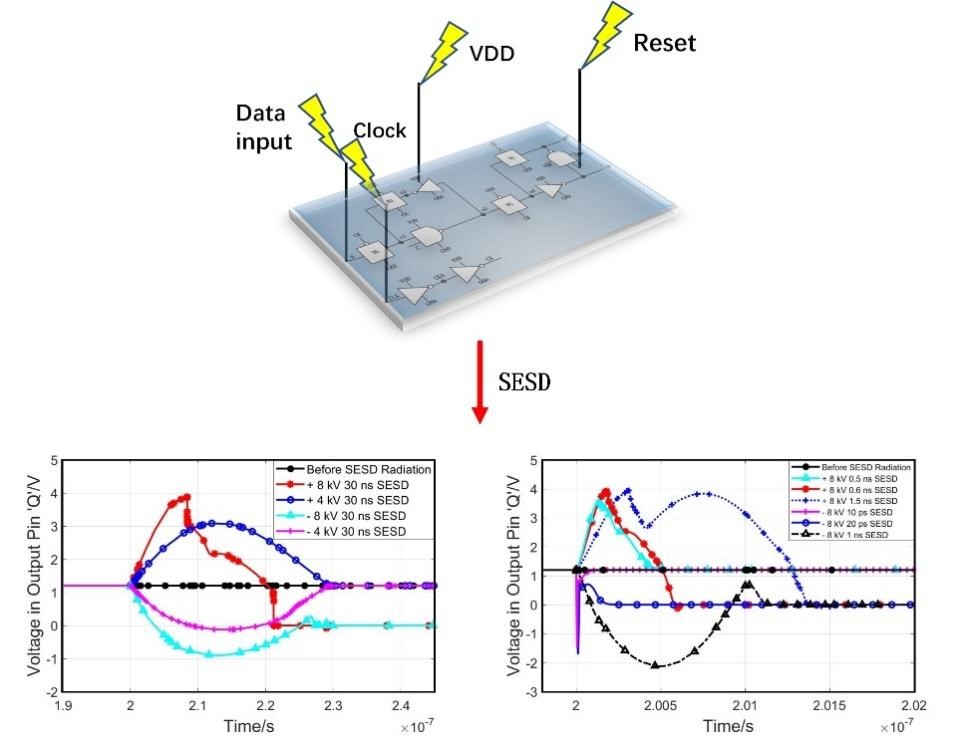
图3. SESD诱发DFF存储数据错误
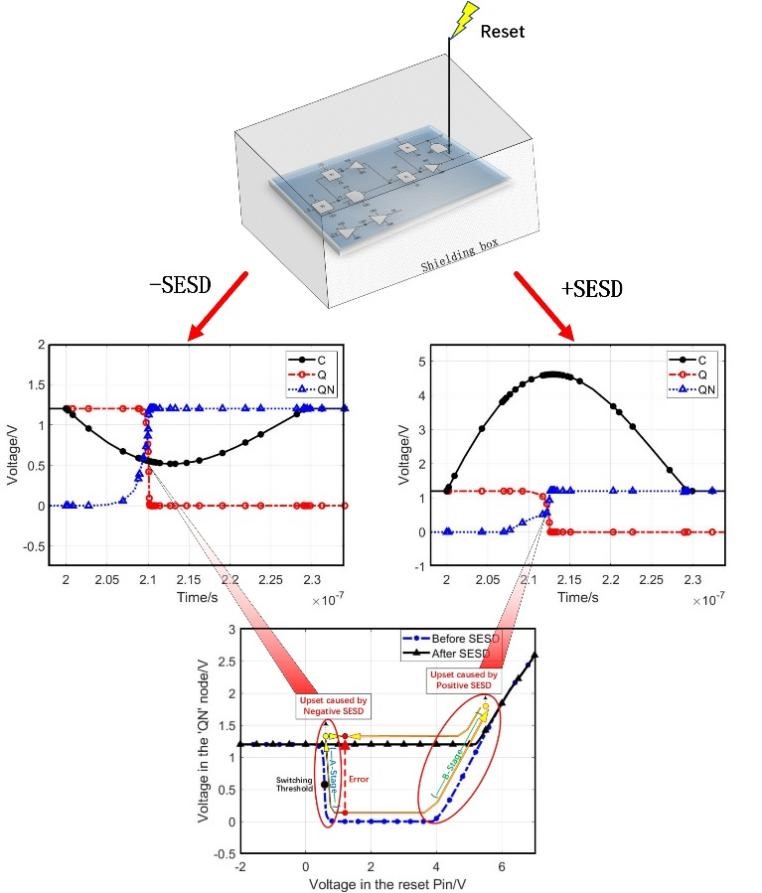
图4. SESD诱发DFF存储数据错误机理
该研究得到国家自然科学基金项目、中科院复杂航天系统电子信息技术重点实验室基金项目的资助,相关成果发表于Microelectronics Reliability [1]上。
[1] R.J. Yuan, R. Chen, J.W. Han, et al, Soft error mechanism in SOI D flip-flop induced by space electrostatic discharge, Microelectronics Reliability, Volume 136,2022,114648.
论文链接:https://doi.org/10.1016/j.microrel.2022.114648