 中文版
中文版
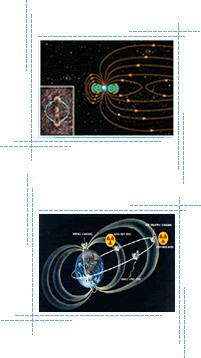
With the Pulsed Laser Single Event Effects facility(PLSEEF), the backside testing of High-performance CPU device based on 90nm SOI-CMOS technology has been done. The abundant SEE phenomena and its effects on the computer performance were observed by the laser scanning. The backside radiation technology can test the internal SEE sensitivity volumes in device directly by avoiding the mental layers from the front side. It’s proved that the pulsed laser was a powerful tool for SEE sensitivity assessment of the devices used in Satellites, and also a tool for the verification of the SEE mitigation techniques.